TOPPAN Electronics Business Unit
FC-BGA基板
关于FC-BGA基板
FC-BGA(FCBGA : Flip Chip-Ball Grid Array)基板是能够实现LSI芯片高速化与多功能化的高密度半导体封装基板。
凸版利用独创发展的微细加工技术和积层布线板技术,开发了超高密度布线结构基板,提供支持半导体工艺微细化需求的产品。
本公司提供从基材设计到制造的全方位支持,需求客户对LSI的多样化应用需求,除PC和游戏机用微处理器和图形处理器外,还包括服务器、人工智能和网络设备用高端处理器,以及高品质车载SoC。
此外,本公司还能够满足无铅及无卤素的需求。

结构与制造工序
FC-BGA的结构
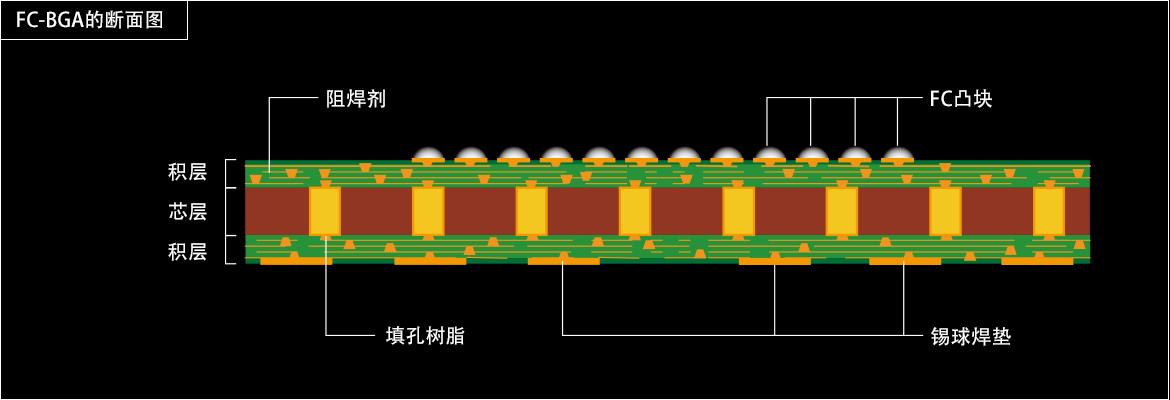
制造工序
-
芯层工序
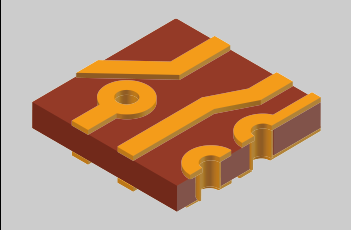
在芯层基板上开孔、镀铜,经蚀刻去除电路部分以外的铜。
-


-
积层工序
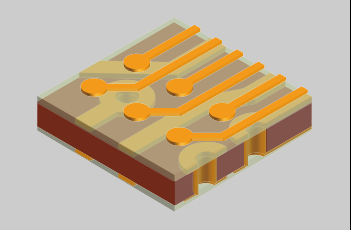
将电路图案进行曝光、并通过镀铜处理直接形成电路。多次重复该工序进行堆叠(积层)。
-


-
外层工序
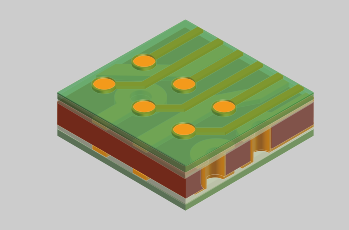
涂布阻焊剂后,在安装LSI芯片(裸片)的部分形成焊接凸块。切割成单个元件后,检查外观及电气特性。
用途
-
 网络设备
网络设备
(ASIC) -
 服务器/电脑
服务器/电脑
(CPU)
-
 AI处理器
AI处理器 -
 车载设备
车载设备
(信息娱乐系统/ADAS)
-
 家用游戏机
家用游戏机
(SoC) -
 图像处理器
图像处理器
(GPU)
产品阵容
-
 FC-BGA
FC-BGA -
 FC-LGA
FC-LGA
-
 多芯片FC-BGA
多芯片FC-BGA -
 超多层FC-BGA
超多层FC-BGA
-
 无芯FC-BGA
无芯FC-BGA -
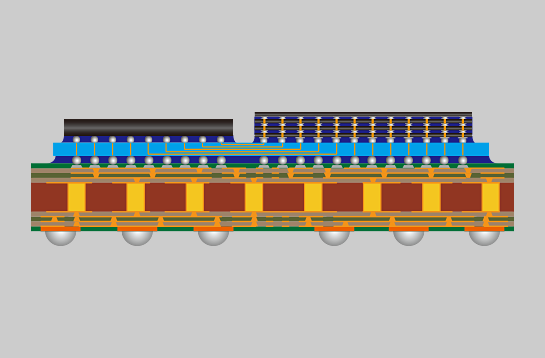 2.3/2.5D封装FC-BGA
2.3/2.5D封装FC-BGA
产品路线图
Buildup - Outer
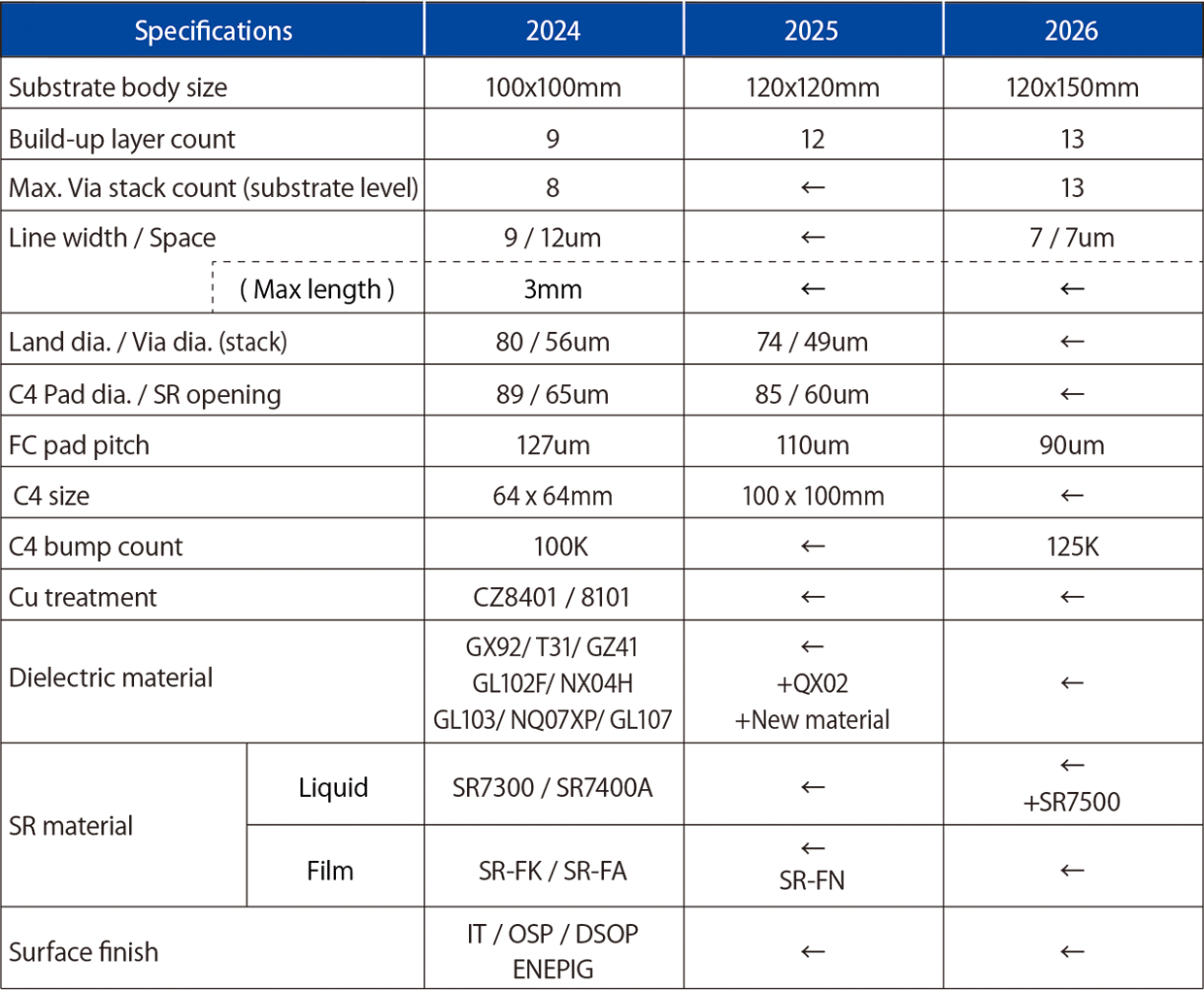
Core
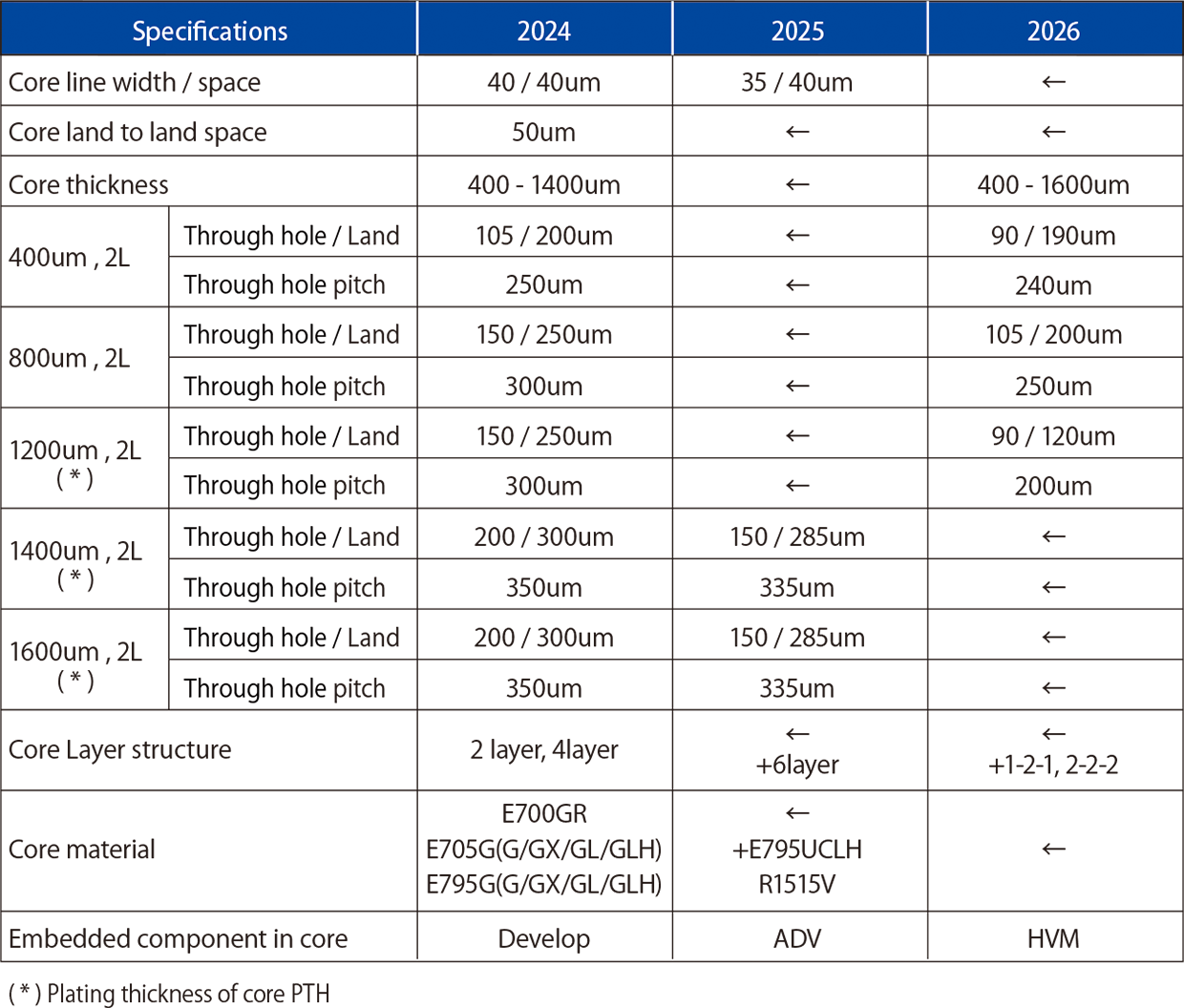
※关于试制/评价用材料,请单独洽询。
特点
应对高密度
-

-
 高密度积层5层堆叠
高密度积层5层堆叠
Land / Via = 85 / 60μm -
 通孔结构10层叠孔
通孔结构10层叠孔
Land / Via = 100 / 60μmm -

窄节距FC凸块
-

-
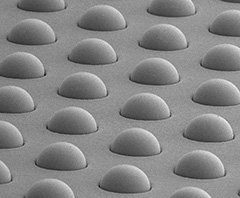 FC凸块Pitch = 130μm
FC凸块Pitch = 130μm -
 FC凸块Pitch = 110μm
FC凸块Pitch = 110μm -

SR坝
铜表面微粗化处理
-
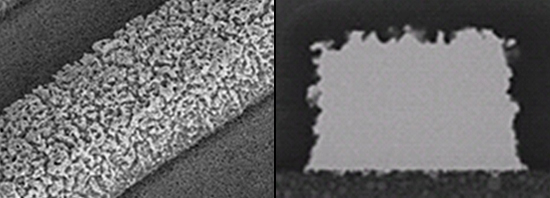 Ra:400-250nm
Ra:400-250nm -
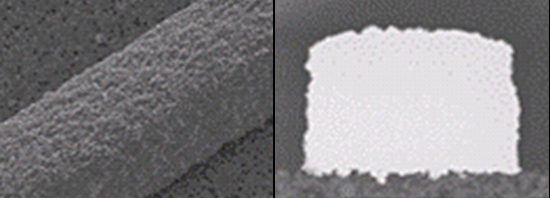 Ra:200-100nm
Ra:200-100nm
多引线化应对/微细布线加工
-
 小节距图案形成(半加成法)Line / Space = 10 / 10μm
小节距图案形成(半加成法)Line / Space = 10 / 10μm -
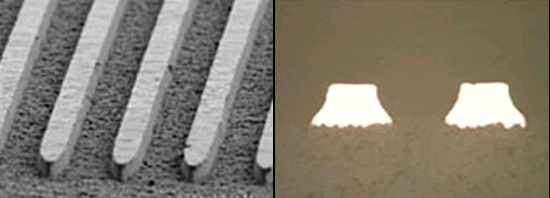 小节距图案形成(减成法)Line / Space = 30 / 30μm
小节距图案形成(减成法)Line / Space = 30 / 30μm
高分辨率阻焊剂图案(正在开发中)
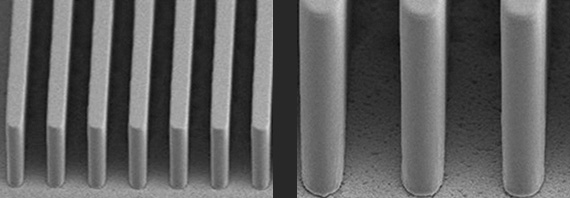
Line / Space = 7 / 7um
高速传输材料
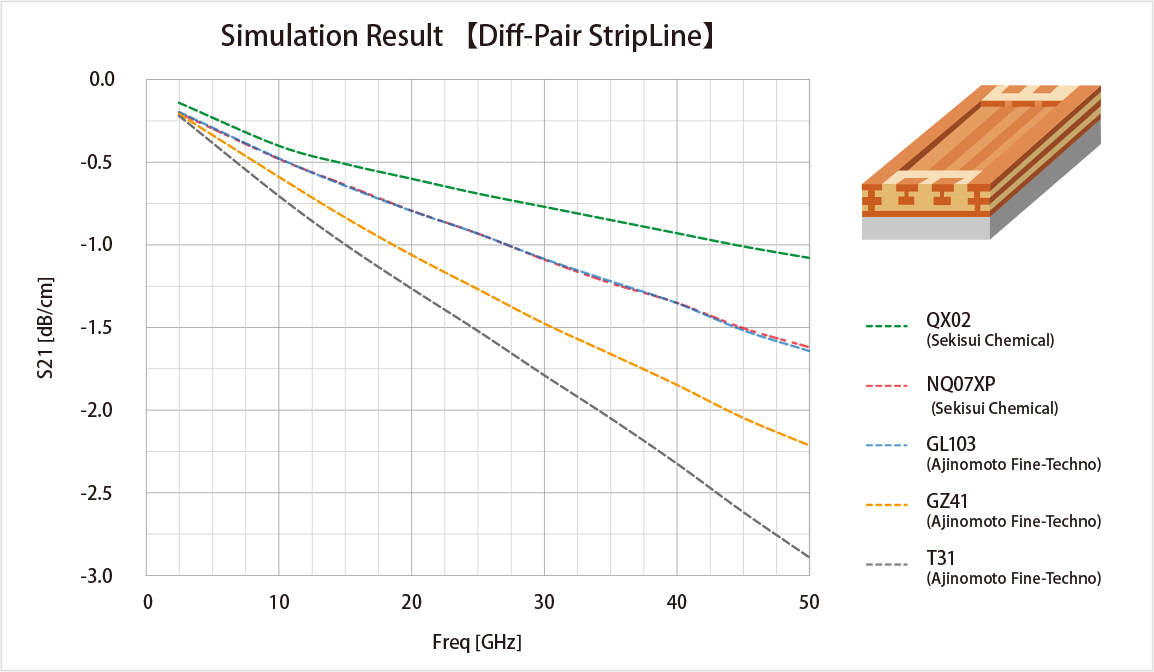
设计、仿真应对
设计流程
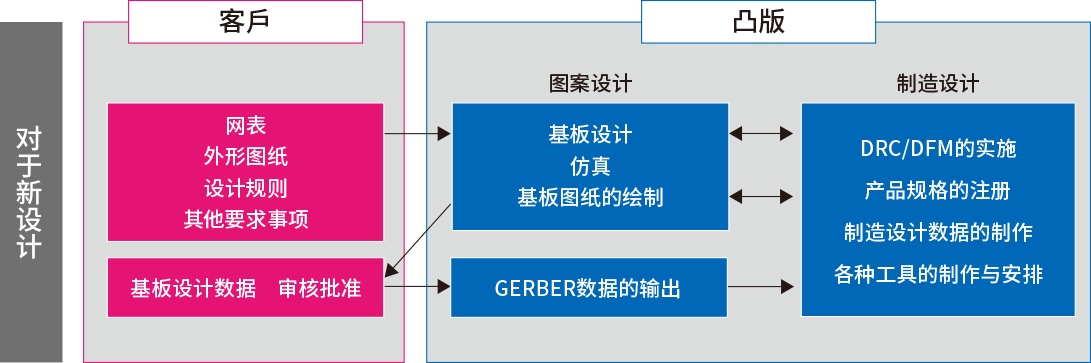
仿真服务
-
导热解析事例

-
电磁场解析事例