TOPPAN Electronics Business Unit
FC-BGA基板
關於FC-BGA基板
FC-BGA(FCBGA : Flip Chip-Ball Grid Array)基板是能夠實現LSI芯片高速化與多功能化的高密度半導體封裝基板。
凸版利用獨創發展的微細加工技術和積層佈線板技術,開發了超高密度佈線結構基板,提供支持半導體工藝微細化要求的產品。
本公司提供從基材設計到製造的全方位支持,需求客戶對LSI的多樣化應用需求,除PC和遊戲機用微處理器和圖形處理器外,還包括服務器、人工智能和網絡設備用高端處理器,以及高品質車載SoC。
此外,本公司還能夠滿足無鉛及無鹵素的需求。

結構與製造工序
FC-BGA的結構
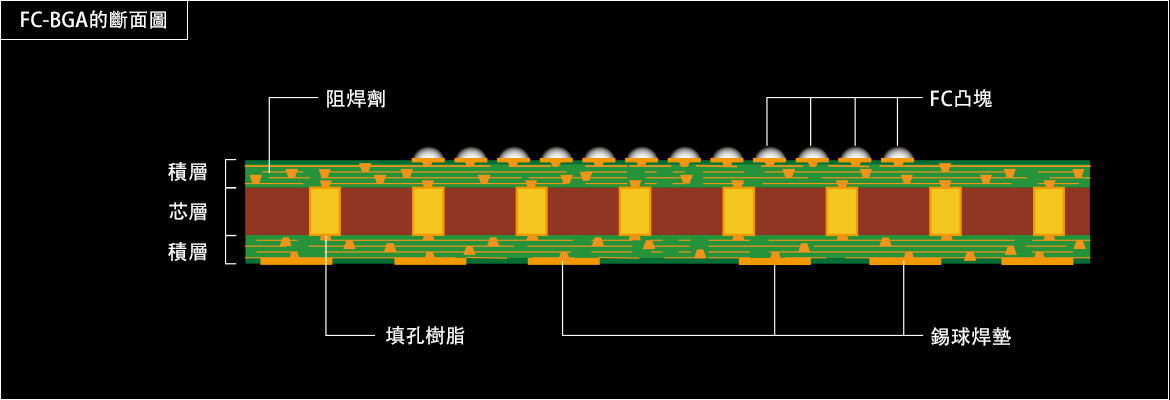
製造工序
-
芯層工序
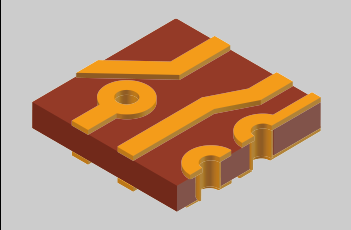
在芯層基板上開孔、鍍銅,經蝕刻去除電路部分以外的銅。
-


-
積層工序
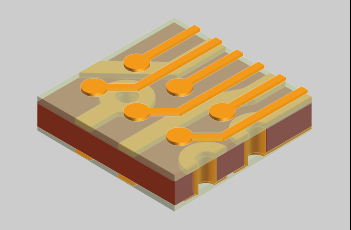
將電路圖案進行曝光,並通過鍍銅處理直接形成電路。多次重複該工序進行堆疊(積層)。
-


-
外層工序
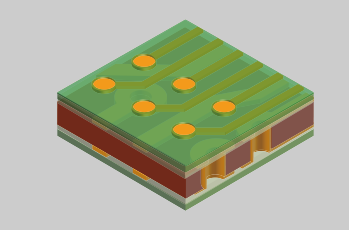
塗佈阻焊劑後,在安裝LSI芯片(裸片)的部分形成焊接凸塊。切割成單個元件後,檢查外觀及電氣特性。
用途
-
 網路設備
網路設備
(ASIC) -
 服務器/電腦
服務器/電腦
(CPU)
-
 AI處理器
AI處理器 -
 車載設備
車載設備
(資訊娛樂系統/ADAS)
-
 家用遊戲機
家用遊戲機
(SoC) -
 圖像處理器
圖像處理器
(GPU)
產品陣容
-
 FC-BGA
FC-BGA -
 FC-LGA
FC-LGA
-
 多芯片FC-BGA
多芯片FC-BGA -
 超多層FC-BGA
超多層FC-BGA
-
 無芯FC-BGA
無芯FC-BGA -
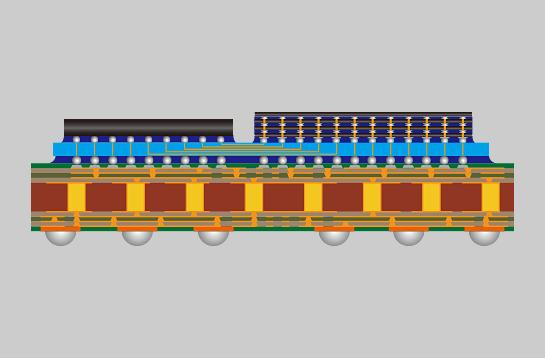 2.3/2.5D封裝FC-BGA
2.3/2.5D封裝FC-BGA
產品路線圖
Buildup - Outer
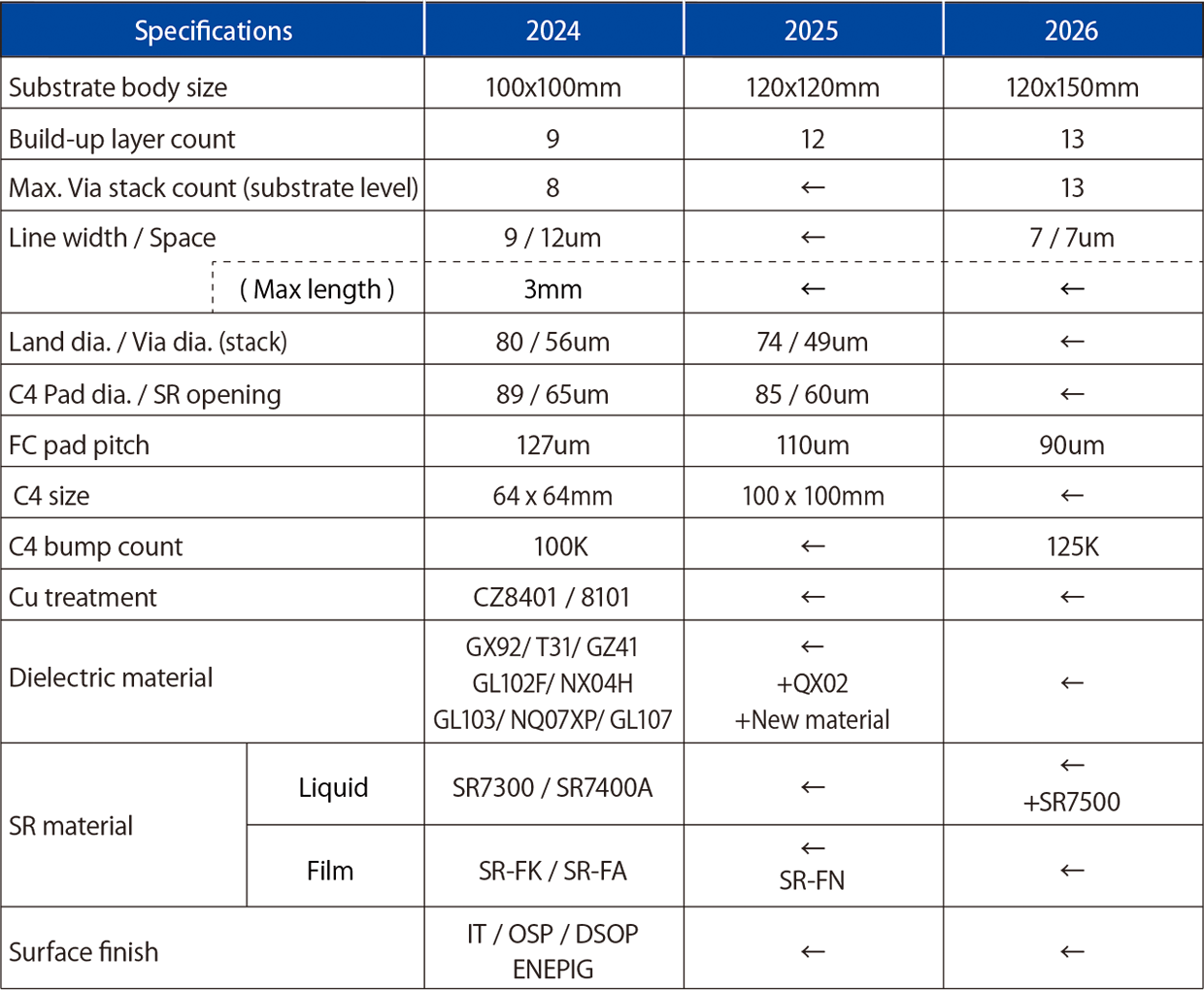
Core
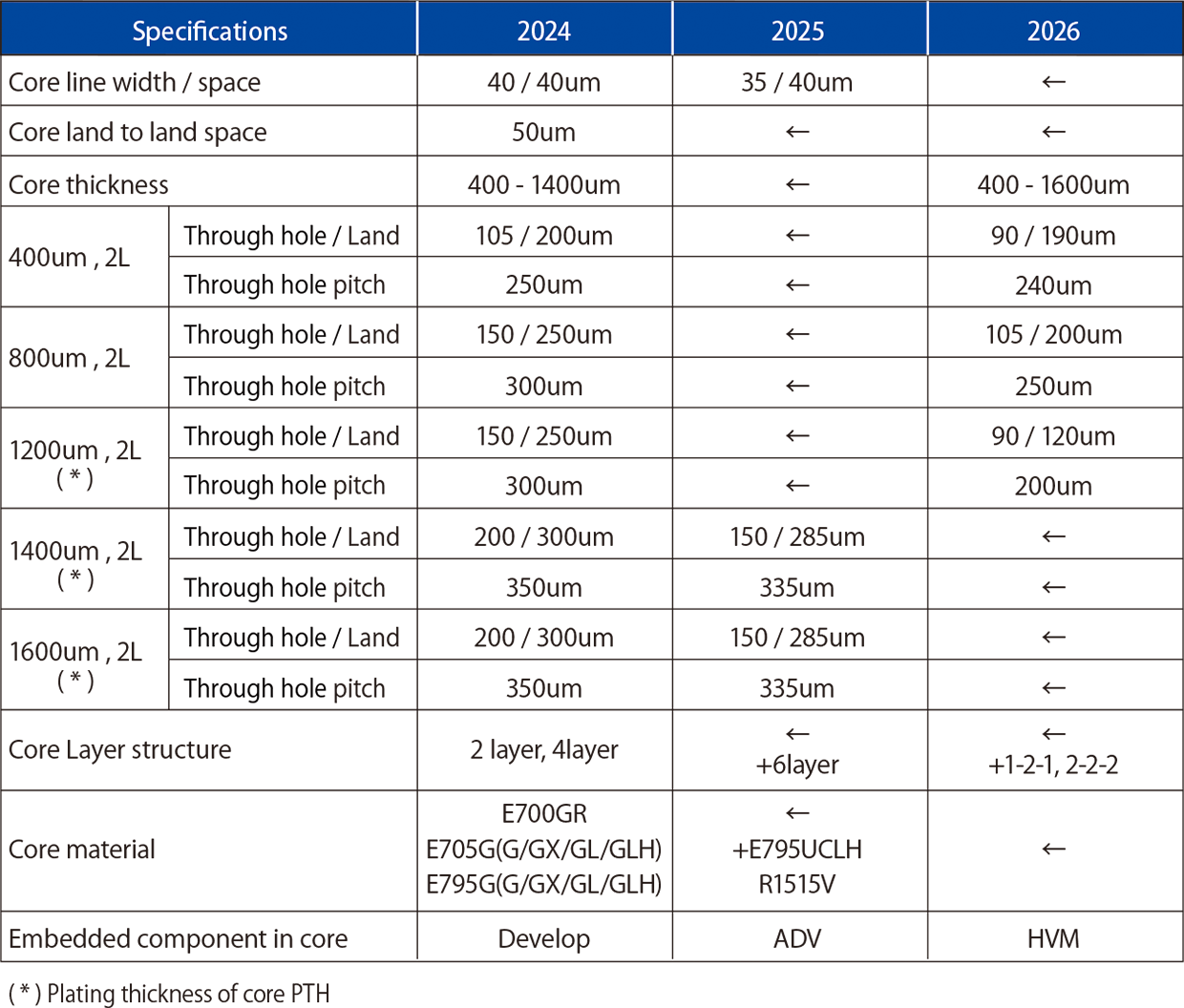
※關於試製/評價用材料,請單獨洽詢。
特點
應對高密度
-

-
 高密度積層5層堆疊
高密度積層5層堆疊
Land / Via = 85 / 60μm -
 通孔結構10層疊孔
通孔結構10層疊孔
Land / Via = 100 / 60μmm -

窄節距FC凸塊
-

-
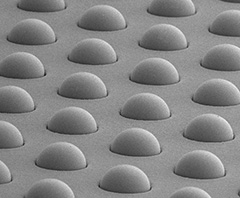 FC凸塊Pitch = 130μm
FC凸塊Pitch = 130μm -
 FC凸塊Pitch = 110μm
FC凸塊Pitch = 110μm -

SR壩
銅表面微粗化處理
-
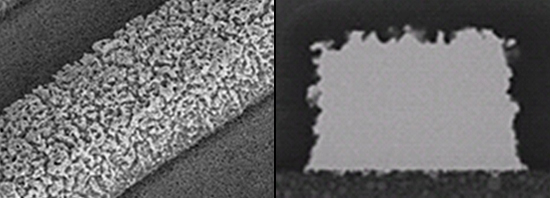 Ra:400-250nm
Ra:400-250nm -
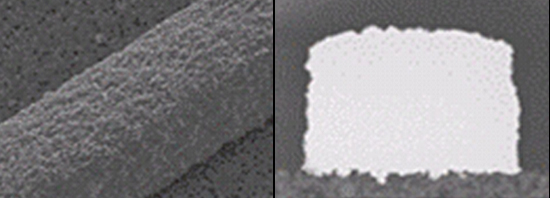 Ra:200-100nm
Ra:200-100nm
多引線化應對/微細佈線加工
-
 小節距圖案形成(半加成法)Line / Space = 10 / 10μm
小節距圖案形成(半加成法)Line / Space = 10 / 10μm -
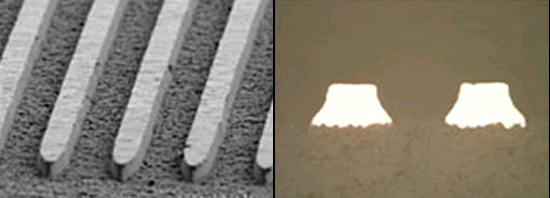 小節距圖案形成(減成法)Line / Space = 30 / 30μm
小節距圖案形成(減成法)Line / Space = 30 / 30μm
高分辨率阻焊劑圖案(正在開發中)
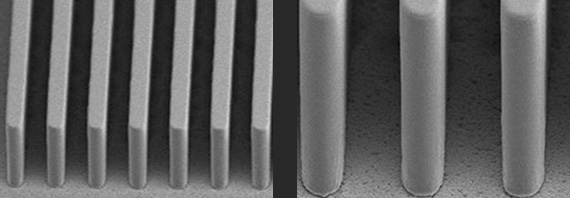
Line / Space = 7 / 7um
高速傳輸材料
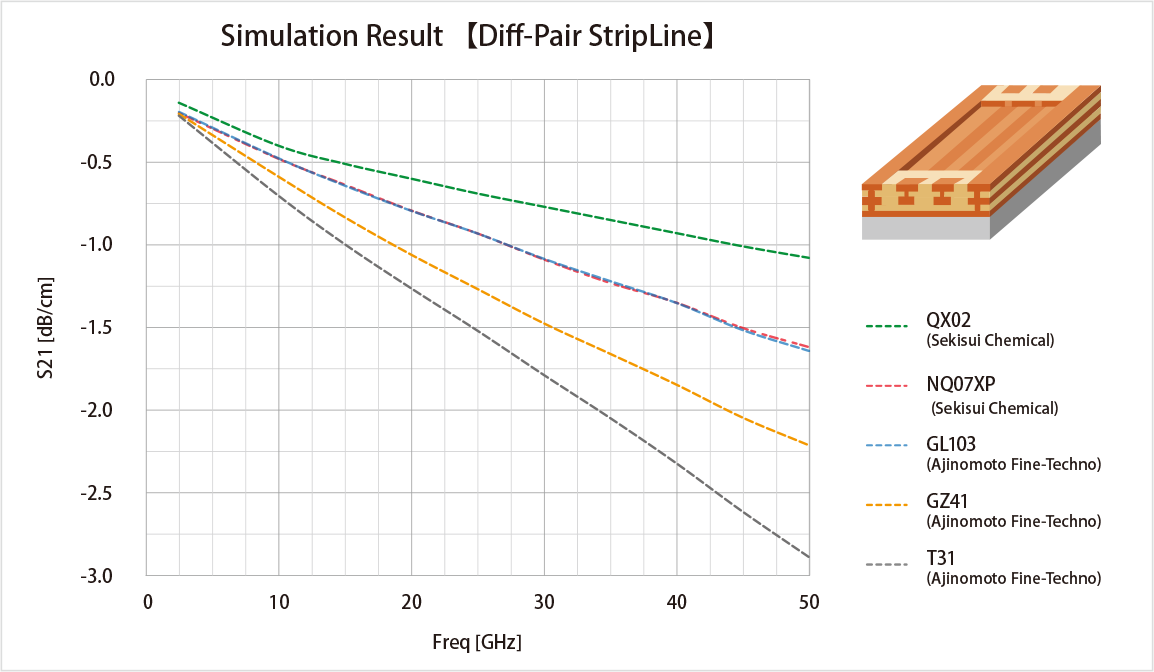
設計、倣真應對
設計流程
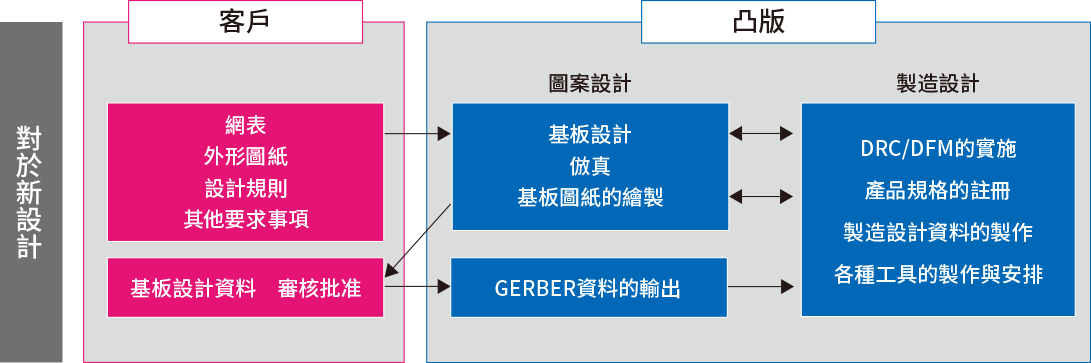
倣真服務
-
導熱解析事例

-
電磁場解析事例